Svepelektronmikroskopi (SEM)
I svepelektronmikroskopet (SEM) avbildas provet genom att en fokuserad elektronstråle scannar över ytan. När de inkommande elektronerna kolliderar med provytan interagerar de med atomerna i provet och en mängd information kan erhållas. Genom att t.ex. detektera och analysera tillbakaspridda elektroner från kollisionen fås information om provets atomnummer och topografi. Analys av röntgenstrålning från exciterade atomer ger information om provets sammansättning (EDX).
Det stora skärpedjupet hos denna teknik gör den lämplig att använda vid analys av ytor med kraftig topografi, t.ex. brottytor. Analyserna kan utföras vid upp till flera hundratusen gångers förstoring med upplösning på några få nanometer.

Resultat (Exempel)

Sekundärelektronbild (SE2) på en skruv med nötningsskador.
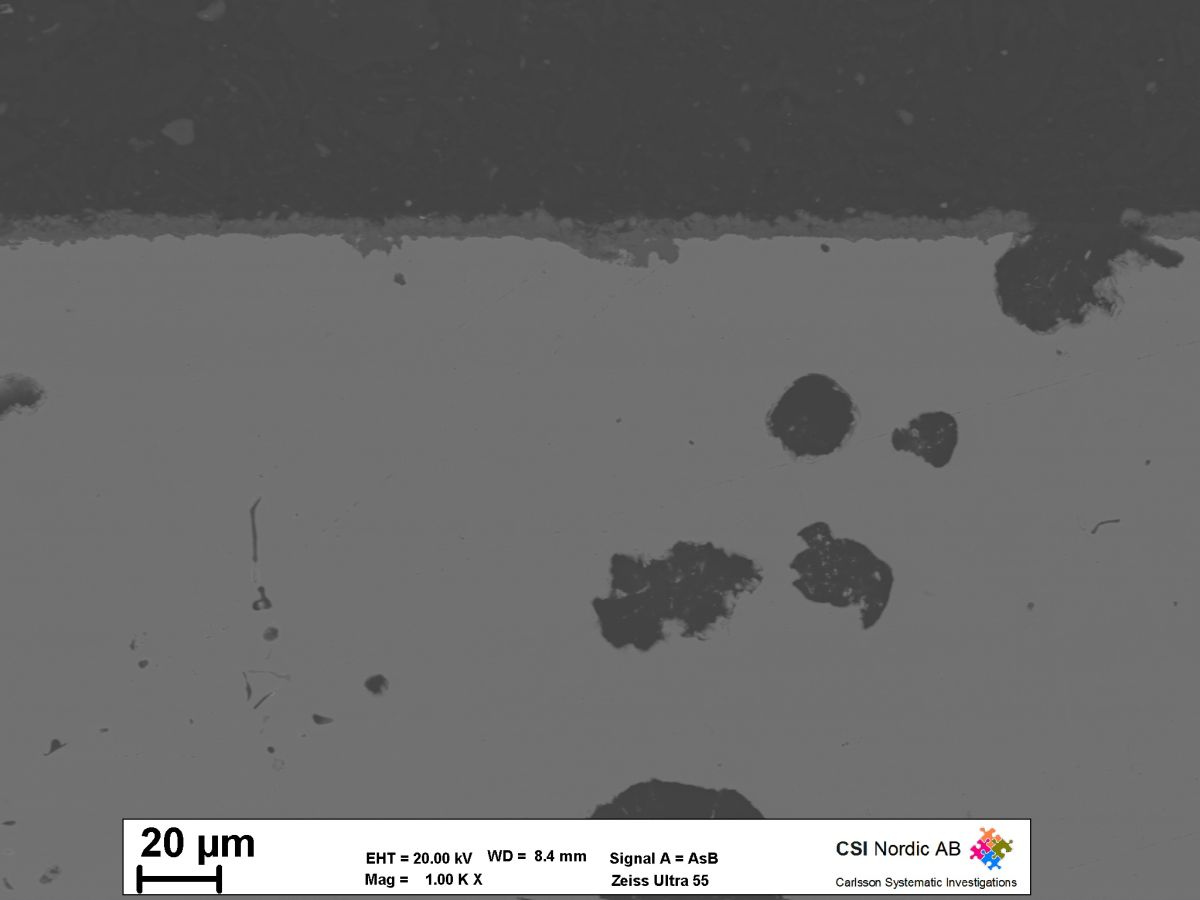
Backscatter-elektronbild av tvärsnitt genom belagt stål.
